全球主要芯片制造商们昨日宣布 ,他们正合作为Chiplet技术创建行业标准,参与该计划的公司包括ASE、AMD、Arm、Intel、高通、三星电子和台积电等,新的行业标准将被命名为UCIe,这一标准或将带来Chiplet的再次变革。
Omdia数据显示,全球Chiplet市场到2024年预计可以达到58亿美元,到2035年将成长至570亿美元。AMD 2021年重磅宣布Chiplet以来,Chiplet的风潮不断冲击半导体行业,而今Chiplet已经扩大到半导体诸多公司。
Chiplet是站在fab角度的一种解决摩尔定律失效问题的方案。2014年,华为海思与台积电的CoWoS(Chip-on-Wafer-on-Substrate)合作产品已经发布。甚至在上世纪末,多芯片技术已经得到研究。除了华为外,其他的中国的企业也在关注Chiplet,称其将带来中国集成电路的重大机遇。
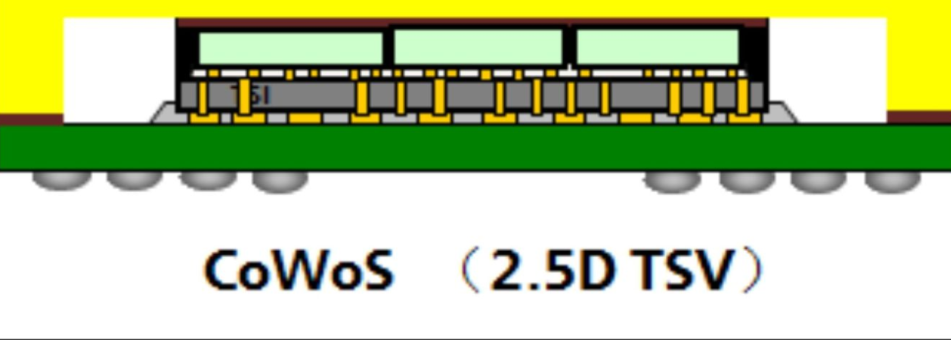
Chiplet现今如何?
AMD将Chiplet带火,也将Chiplet做精,英特尔则后发赶上,在IDM2.0的规划下,GPU、CPU和技术节点上也开始进行Chiplet的尝试。
2020年的国际固态电路峰会(ISSCC)上,AMD发布了基于Zen 2的服务器产品的多种Chiplet策略,只要三种die即可以创建产品,Chiplet在AMD服务器芯片上的应用正式打开市场局面。

去年,AMD发布了其3D封装技术,这是AMD与台积电联合研发的用于CPU封装的技术,AMD Ryzen9 5900x处理器就运用了3DChiplet,其采用了64MBL3缓存堆叠64MBSRAM,将16核处理器上使可用的L3缓存增加三倍。这种封装使得晶体管排列密度比常规的2D封装高出200倍。
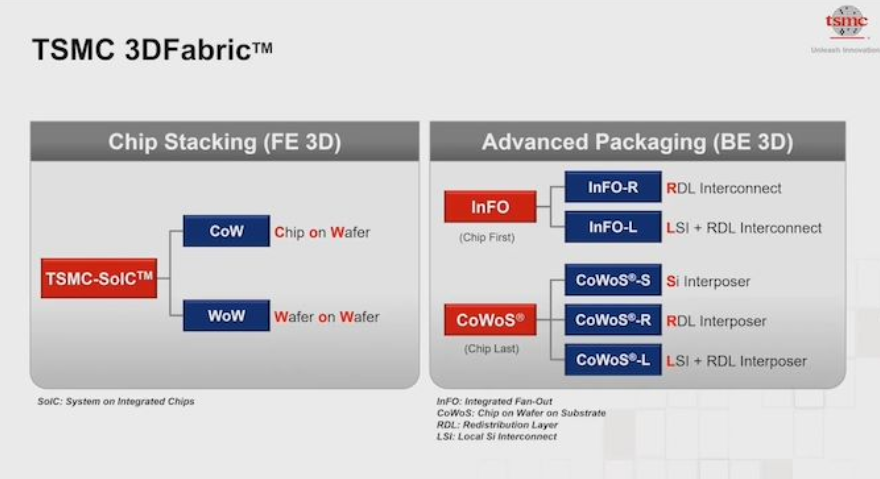
上个月,AMD在ISSCC 2022上再次透露了其Chiplet设计最新技术细节。AMD Ryzen7 5800X 3D将成为第一款包含额外堆叠缓存的消费级处理器,这是AMD最前沿的封装产品。每个Zen 3 Chiplet将包含32MB的L3缓存,由所有八个片上内核共享,无需进行基本的重新设计即可堆叠额外的缓存。
无独有偶,在ISSCC 2022上,英特尔也公布了其Chiplet最新产品。本次,英特尔公布了将为Aurora超级计算机提供动力的处理器Ponte Vecchio的新细节,英特尔将3100平方毫米的晶体封装到2330平方毫米的芯片中,47块硅晶体有超过1000亿个晶体管。Ponte Vecchio处理器是使用英特尔2D集成技术Co-EMIB捆绑在一起的两个镜像Chiplet集。
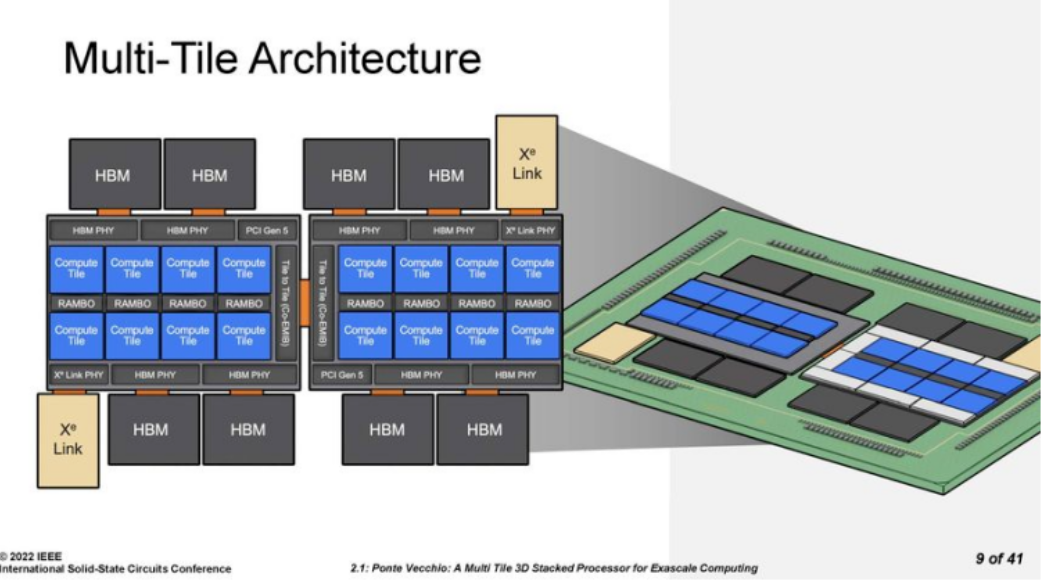 早在去年,英特尔使用名为Foveros的Chiplet方法推出了3D CPU平台。这在一个封装中结合了一个10nm处理器内核和四个22nm处理器内核。
早在去年,英特尔使用名为Foveros的Chiplet方法推出了3D CPU平台。这在一个封装中结合了一个10nm处理器内核和四个22nm处理器内核。
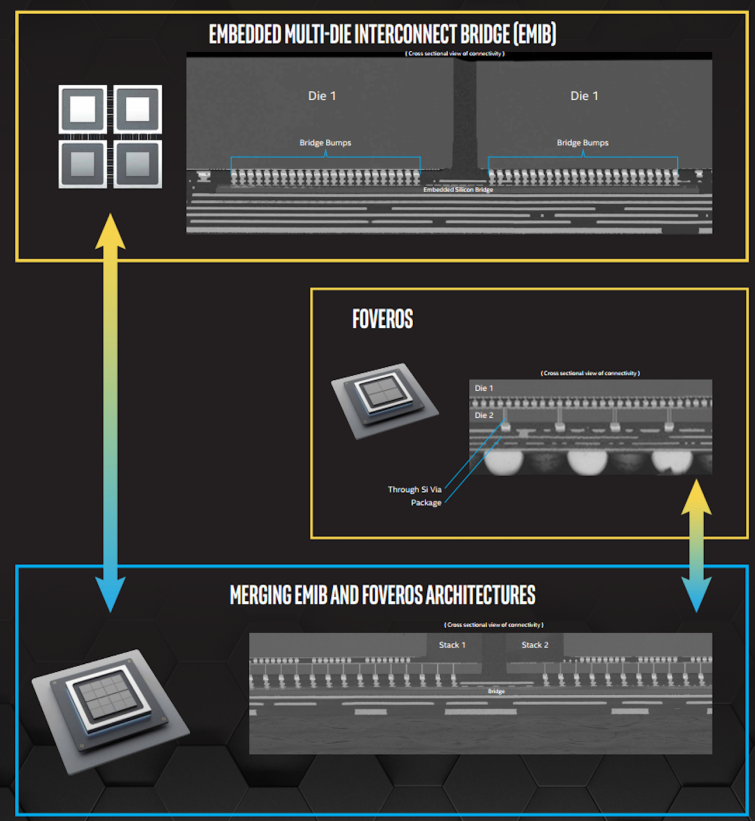
积极追赶的国内公司
国内公司也在积极关注Chiplet。相关人士表示,在后摩尔时代,Chiplet给中国集成电路产业带来了很多发展机遇。众所周知,先进工艺制程的设计和生产成本很高,而且高端工艺主要由少数几家领先的晶圆厂来供应,往往产能有限。在成本、供应都受限的情况下,用Chiplet这种将不同工艺节点的die混合封装在一起的方式,是未来芯片的重要趋势之一。
华为是国内最早尝试Chiplet的一批公司,海思半导体在早期就与台积电合作过Chiplet技术,在技术封锁之下,Chiplet可能会成为华为渡过难关、保持劲头的一种解决方案。去年,有消息传出,华为正在尝试双芯片叠加,将利用3DMCM封装的Chiplet。
除华为之外,也有其他国产半导体公司也有了惊喜的进步。国内公司芯动科技表示,国内首款高性能服务器级显卡GPU“风华1号”回片测试成功。该GPU使用了INNOLINK chiplet技术,芯动科技推出的国产标准封装技术,将不同功能不同工艺制造的Chiplet进行模块化封装,成为一个异构集成芯片。
此外,芯原科技也是国内为数不多提供Chiplet芯片设计的公司,其采用Chiplet架构所设计和推出的高端应用处理器平台用了12个月完成了从定义到流片返回。芯原科技表示,公司的高端应用处理器平台集成了大量IP,包括NPU、ISP、视频处理器和显示控制器等。该平台主要面向手机、平板电脑、笔记本电脑等应用,同时还适用于自动驾驶。
芯原科技董事长戴伟民曾说,Chiplet项目非常适用于汽车产品,将计算和功能模块做成一颗颗积木一样的Chiplet,每一颗Chiplet单独做好车规验证工作,然后在升级汽车芯片的时候,像搭积木一样拼装起来,当性能要求越高越多,加进去的Chiplet就越多,而不需要每次升级都重新从头设计一颗大芯片,然后重新走车规流程。这种模式也可以增加汽车芯片的可靠性。
Chiplet不会主导市场
前面提到,AMD、英特尔、台积电、Marvell等已经开发或演示了使用Chiplet的设备。然而,Chiplet在产品进步之外,仍存在许多瓶颈。
此前,由于生态系统问题、缺乏标准和其他因素,业界对Chiplet的采用受到限制。
Chiplet的目标是通过将预先开发的芯片集成到 IC 封装中来减少产品开发时间和成本,因此可以在不同的节点上具有不同的功能。客户可以混合和匹配Chiplet,并使用die到die互连方案将它们连接起来。多年来,有几家公司推出了类似Chiplet的设计,但该模型朝着无法预期的方向发展了下去。
本来对于高级设计,业界通常会开发片上系统(SoC),设计公司可以在其中缩小每个节点的不同功能并将它们封装到单芯片上,但是这种方法在每个节点都变得越来越复杂和昂贵。这是Chiplet发展的最主要原因,但也是其无法跨越的本质。
由于设备的类型和数量不断增加,不是所有产品都会采用基于小芯片的方法。在某些情况下,单片芯片仍将成为成本最低的选择。开发基于Chiplet的产品需要良好的Die、EDA、芯片到芯片互连技术。目前,往往是垂直整合的公司在研究Chiplet,因为并非所有公司都拥有内部组件。找到必要的部分并将它们整合起来,需要大量的时间和资源。
如果行业想要转向支持基于Chiplet的集成系统,那不同的公司必须开始相互共享芯片IP。这是一个很大的障碍,他与过去的生意传统相悖,即使建立标准接口,也需要设计公司、制造公司的一致努力。
本次,Intel、AMD等一众公司提出新的Chiplet标准UCIe将改善这一困境,我们应该很快技能看到Chiplet的新一波爆发。
总体来说,单片芯片到了先进制程,很少有公司能够在高级节点上负担得起高昂的成本。Chiplet相对更有成本空间,将会是一种补充方案。与其说Chiplet是未来的主流,倒不如说Chiplet会给处于发展平台期中国集成电路企业另外一种思考方式。














